
文章图片

文章图片

文章图片
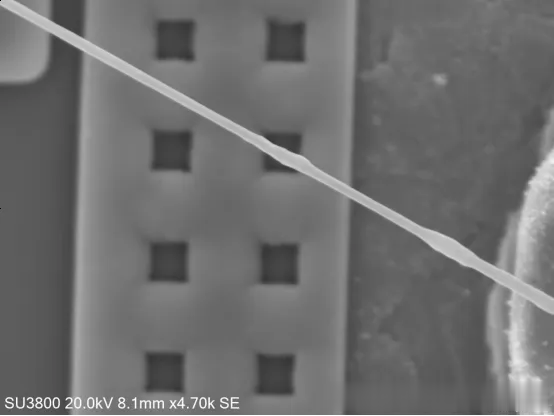
文章图片

失效分析 赵工 半导体工程师 2025年06月27日 08:21 北京
Q1
大家有遇到过MCU在运行中VDD键合丝熔断的情况吗?4根键合丝熔断3根 , 在ADC部分的GND通道上有热点 。
A1
应该是内部短路后 , 引起的烧毁吧 , 剩下焊线是有焊点脱落开路吧 , 不然它怎么能不熔断 , 建议1.做一下浪涌 , 2.做全套的LU , 芯片的其他管脚发生LU , 也是表现在电源上大电流 。
Q2
针对Shadow moire report实验 , 行业翘曲度标准大概是什么范围算合格?
A2
-/+80um , 要看导入数据时框选位置 , 一般的84大概率是四角相对参考平面的值 , 要是角上放的是VSS或者Dummy , 风险不高的 , 只看80是理论家的做法 , 款选位置对测量数据的影响较大 , 且框选是手动的 , 不能精确到具体的尺寸;Shadow moire 测量是热变形 , 温区曲线最好follow客户SMT曲线;84要具体看是高温区间 , 还是低温温区 , 高温区影响比低温区大一些 。
Q3
一般产品都不做LTOL或者很少做 , 做HTOL比较多 , 那客户如果问起来为什么不做LTOL , 可以怎么解释起来合理一些?另外根据HTOL的试验时间是不能等效到低温-40℃的寿命吧?低温有专门的寿命模型吗?
A3
LTOL主要失效模型是HCI , 可以用Fab的HCI结果替代 , HTOL和LTOL机理不同 , 不能等效 , HTOL是多方面综合的 , 其中TDDB占多数 。
Q4
帮忙推荐一下划片厂 , 要能经受客户验厂的那种 , 产品是硅片 , MPW的 , 一片上有三种型号 。
A4
可以找季丰 , 季丰可以做划片的 。
Q5
一款芯片的抗ESD能力 , 有没有可能HBM很弱 , 但MM很强?
A5
有可能 , 我也见过 , 和设计的策略有关 , 主要是由于内部电路设计的差异、ESD保护策略的不同以及测试条件和标准的差异所导致的 。
Q6
晶圆研磨供应商变更了 , 一般需要做什么验证?这个AEC-Q100里也没有对应的项目 。
A6
参考红框圈出的来做实验 。
Q7
有没有人遇到过在不同机构测试ESD , Latch up结果不一样的?
A7
同一家机构 , 甚至同一台设备都碰到过结果不一样的 , 如果发现有这种现象 , 还是要多Debug , 在一些对于某些参数敏感的时候 , ESD测试起来还是有一些Options的 。
Q8
TC用的两箱法 , 两个温区分别是-55 , 150℃ , 每个温区保存15min , 机械传动材料的方式进行轮换 , 一个小时2个循环 , 这样是不是就做成热冲击了?正常那种带升温和降温的TC是怎么做的?
A8
高低温中间有个常温静置步骤 。
Q9
对于wafer出货的IC , IC本身这边可靠性需要做些什么项目?客户那边拿我们的IC自己去进行合封 。
A9
芯片本身肯定要先做开发板测ESD和HTOL那些可靠性 , 整wafer出货就主要靠CP良率来卡控了 , 另外就是靠WAT监控工艺波动 , 可靠性要求高的话 , 就得看做CP三温测试 , 另外要看有没有Flash , 有Flash的话要做存储老化CP再出货 。
Q10
有谁做过动态Latch up测试吗?哪里可以做?
A10
要罐pattern , 这个需要机台的一个模块控制 , 目前几乎没有人做 , 所以市面上也几乎是没有去配这个模块 , 一般是单独定制测试板 , 给予一些外围电路 , 让IC工作再去做Latch up 。
Q11
我用NaOH溶液去掉了铝线 , 那芯片上的黄色和灰色是什么材料?
A11
如果能提供更加清晰的照片会更加容易分辨 , 正常都是TIN , 厚度不同在OM下的颜色深浅有差异 。
Q12
下图这种白斑大家碰到过吗?是怎么造成的?
A12
是via位置的绿油分层起泡 , 找你们基板供应商 。
Q13
在消费类产品做LU的过程中 , 什么情况下 , 需要在Tj=125度下进行测试 , 而不是常温下进行测试?
A13
一般是预留转车电的芯片会做一下 。
Q14
如下为什么非要用陪片?
A14
验证环境是不是可靠 。
Q15
对于车规TO MOS产品 , N管和P管都要做AEC Q101认证吗?
【芯片分析问答25.6.26】
A15
每个产品都要过认证 , 根据产品分类来看使用Q100 , 101 , 102 , 103 , 104 。
Q16
长期存储的MSL1级产品需要考虑受潮问题吗?
A16
不用 , MSL1的标准就是可以无限期放置的 。
Q17
高温回流焊会导致功能失效 , 参数漂移吗?
A17
参数漂移会 , 功能失效不一定 , 当然会有功能失效风险 , 比如分层蹿锡短路 , 爆米花开路 。
Q18
QNF封装BHAST做完2倍stress(192hrs)后出现分层的情况 , 有遇到过吗?按车规AEC-Q006的要求 , 这种算可接受吗?
A18
环境实验 , 是不卡分层的 , 只有MSL实验才卡分层 , 但是也要看具体分层情况 , 是否有非功能性失效 , 客户能否接受 。
Q19
对于芯片的FIT值 , 是用来衡量芯片的哪个角度的指标呢?
A19
MTTF 和 λ , FIT越低越好 , 但是可以随着量产时间及样品数量的增加而降低的 。
Q20
2.5D的封装成本比2D的封装成本增加几倍(在相同的5个die且基板差不多规格的情况下)?
A20
之前了解到Silicon interposer 2.5D价格应该是MCM的接近10X数量级了 , 具体价格case by case吧 。
Q21
BGA产品锡球脱落(FT时发现) , 锡球脱落是有标准的吗 , 还是不允许锡球脱落?
A21
不允许锡球脱落的 。
Q22
只有测芯片EMI的 , 那对于芯片的EMS有测试标准吗?
A22
本身芯片级的EMC就是个nice to have的测试 , 标准也没有规定go-no-go的曲线 , 都是让与终端客户协商来定 , 系统板子有很多手段治理EMI和EMS的问题 , 比如加屏蔽 , 加衰减泄放通路等 , 系统级必须要过强制的标准 , 有严格的标准曲线 , 但是也确实遇到过系统上很难解决的EMI问题 , 最后还是芯片改版解决的 。
Q23
封装过程开帽发现丝状异物 , 大家有没有遇到过该异常?
A23
先做EDX看是什么东西 , 从分布来看 , 有点像劈刀磨损导致拉丝 , 如果是异物的话 , 很难有这种拐弯和这么好的韧性 , 导致molding注塑时都没有被冲开 。
来源:季丰电子
半导体工程师
半导体行业动态 , 半导体经验分享 , 半导体成果交流 , 半导体信息发布 。 半导体培训/会议/活动 , 半导体社群 , 半导体从业者职业规划 , 芯片工程师成长历程 。
推荐阅读
- 中国专利金奖:每小时数万颗芯片“微米级极速取放”
- 英伟达麻烦了?OpenAI转向谷歌TPU芯片,大家开始去英伟达化?
- 微软下一代AI芯片推迟至2026年量产
- 华为将带来三款折叠屏手机,麒麟芯片曝光
- 年出货112亿颗,全球最大汽车CIS芯片厂商,在中国
- 大陆唯二可自研5G基带!国产手机芯片第一股上市在即
- 国产CPU大胜利!纯自研自产12nm,不输国外7nm芯片
- 年出货16亿颗,全球第4、中国大陆第1的手机芯片厂,要上市了
- ASML的路要断了,因为1.4nm芯片,已贵到你用不起了
- 中国企业疯狂下单?日本芯片设备卖爆了,创下历史纪录














