
文章图片
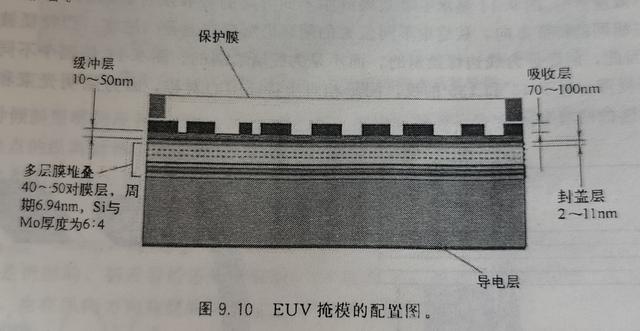
文章图片
前沿导读在2024黑龙江省高校和科研院所职工科技创新成果转化大赛当中 , “核工业自动化检测维修机器人”和哈工大先进技术研究院申报、航天学院赵永蓬教授研发的“放电等离子体极紫外光刻光源”两个项目获得大赛一等奖 。
“放电等离子体极紫外光刻光源” , 具有能量转换效率高、造价较低、体积较小、技术难度较低等优势 , 可提供中心波长为13.5nm的极紫外光 , 能够满足极紫外光刻市场对光源的需求 , 为推动我国极紫外光刻领域发展、解决高端制造领域关键问题作出了贡献 。
EUV光源这次哈工大在EUV光源技术上面有了技术突破 , 但是只限于是放射光源 , 并没有涉及EUV光刻机的整机供应链 。 说突破了光源 , 就是突破EUV光刻机的这种言论 , 是非常错误的 , 而且是非常无厘头的 。
ASML是目前全球唯一的EUV光刻机供应商 , ASML的EUV光源是美国西盟与德国通快公司合作制造的产品 , 目前西盟公司已经被ASML收购 。
西盟公司属于美国EUV LLC技术联盟的企业 , 负责极紫外光源的技术研发 。
EUV的极紫外光主要是由放电等离子体 , 或者激光等离子体产生 , 经过行业的技术测试 , 激光等离子体光源成为了行业共识 。
极紫外光源属于是人眼不可见的光线 , 想要将这种光线投入到芯片的制造当中 , 需要用到锡元素的连锁反应 。
- 以大约每小时200英里的速度 , 在真空中射出一个三千万分之一米直径的小锡球 , 然后用激光照射锡两次 。
- 第一次脉冲加热锡 , 第二次脉冲将锡球轰成温度约为50万摄氏度的等离子体 , 这个温度比太阳的表面还要高 。
- 然后将轰锡的过程每秒钟重复5万次 , 才可以让极紫外光达到制造芯片的合格水平 。
在制造EUV光源发射器的时候 , 西盟和通快用了四种装置打造而成 。
两个种子激光器、四个增加光束功率的谐振器、高精度的光束传输系统、聚焦装置 。
在初代EUV光刻机的制造过程中 , 西盟和通快用了10多年的时间 , 攻克了EUV光源的激光发射器技术 。 一个合格的EUV激光器 , 需要用到45万+的零部件 。
EUV的工艺难点除了EUV的光源发射器 , 与之匹配的掩模也是一个相当有技术含量的东西 。
以往浸润式DUV光刻机的掩模板 , 最小周期为320nm 。 而EUV光刻机的掩模板 , 最小周期需要保持在160nm以及更小的数值 。
想要匹配掩模板 , 掩模板的写入器必须要将分辨率提升到一定的精度 。 此外 , 掩模检查还需要光化光步骤 , 以往的DUV掩模板根本无法应用在EUV上面 , 需要重头开发新的匹配工具 。
EUV掩模是一个反射式掩模 , 由一个衬底、一个多层膜堆叠、一个封盖层、一个缓冲层、一个吸收层组成 。
对于掩模衬底来说 , 这种材料的热膨胀系数必须要比石英低 , 平整程度要做到10nm以内 。 在进行多层膜堆叠的步骤之前 , 掩模衬底不能有任何瑕疵以及细小颗粒 。
封盖层、缓冲层、吸收层 , 这三个是需要同步进行的连锁反应步骤 , 为了让吸收层正常工作 , 必须要让缓冲层来保护多层膜免受刻蚀和其他相关处理步骤的损坏 。 封盖层可以保护多层膜免受环境的腐蚀 , 缓冲层保护多层膜免受刻蚀的损坏 , 并且缓冲层还可以在修复过程中保护多层膜 。
对于EUV的投影光学器件来说 , 其组件的平滑度对于减少杂散光至关重要 。
掩模的反射 , 使光学元件中纵向表面变化的光程差加倍 。 反射元件比折射元件要灵敏得多 , 为了保持相同水平的杂散光 , 反射表面的粗糙程度和结构必须比折射表面好4倍左右 。
在193nm波长的DUV基础上进行EUV数值的转换 , 13.5nm / 200=0.067nm , 这个元件的数值 , 相当于原子尺寸中的很小一部分 。
由于用EUV技术在商业领域制造芯片的巨大成功 , 因此国内外的许多科研机构 , 都已经在物理、化学、材料、工艺、计量等科研方面建立起了相关的技术产业链 。
如果要继续推动EUV技术在商业领域的发展 , 需要想办法进一步提高光源功率 , 但是提高功率之后 , 还需要考虑热效率导致的损害和缺陷 。 并且要重新开发与之匹配的光刻胶 , 光刻胶需要吸收更多的光子 , 并且不能牺牲CD控制和光刻胶附着力 。
【哈工大突破EUV光源技术,距离国产EUV又近了一步,但差距依然很大】EUV技术 , 最开始是打算在90nm节点进行扩展的 , 但是由于EUV光刻机的各个环节需要投入大量的资源 , 一直到7nm节点 , EUV技术才正式进行了商用 。
推荐阅读
- 重磅突破!国产EUV光源技术获奖,芯片制造迎来新曙光
- 下一代EUV光源,美国再次领先,芯片制造效率飙升十倍!
- AI爆火两年,技术飞快跑,大模型突破商业化困局了吗?
- 芯片突围!哈工大、华科大点亮“中国芯”曙光
- 明年Galaxy S26影像有望大突破!曝三星正开发5亿像素感光元件
- 华为畅享 70X升级超感光影像,突破人像摄影新境界
- 哈工大再传喜报!成功研发13.5纳米极紫外光源,光刻机突破在即
- 10台EUV光刻机!中芯国际突然宣布,外媒:更可怕的还在后面
- 哈工大公布关键消息,ASML猝不及防,外媒:基本挡不住了
- 国产EUV光刻机:打破美国芯片禁令的关键王牌
















